Method and Device for Controlling the Generation of Ultrasonic

Wire Bonding is the most widespread technology for chip interconnects due to its advantages such as flexibility, reliability and competitive speed of the process. It is suitable for a wide range of packaging approaches as for example: lead-frame, ceramic thick film and chip on board, with different metallization on the chip as well as on the carrier/ substrate. The problem with hitherto existing methods to control the wire bonding process is that these do not always yield optimal results and do not work in real-time.
Further Information: PDF
ipal GmbH
Phone: +49 (0)30/2125-4820
Contact
Ursula Haufe
Media Contact
All latest news from the category: Technology Offerings
Newest articles

Recovering phosphorus from sewage sludge ash
Chemical and heat treatment of sewage sludge can recover phosphorus in a process that could help address the problem of diminishing supplies of phosphorus ores. Valuable supplies of phosphorus could…
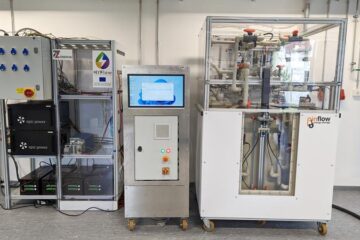
Efficient, sustainable and cost-effective hybrid energy storage system for modern power grids
EU project HyFlow: Over three years of research, the consortium of the EU project HyFlow has successfully developed a highly efficient, sustainable, and cost-effective hybrid energy storage system (HESS) that…

After 25 years, researchers uncover genetic cause of rare neurological disease
Some families call it a trial of faith. Others just call it a curse. The progressive neurological disease known as spinocerebellar ataxia 4 (SCA4) is a rare condition, but its…

















